QR ကုဒ်

ကြှနျုပျတို့အကွောငျး
ထုတ်ကုန်များ
ကြှနျုပျတို့ကိုဆကျသှယျရနျ


ဖက်စ်
+86-579-87223657

အီးမေး

လိပ်စာ
Wangda လမ်း၊ Ziyang လမ်း၊ Wuyi ကောင်တီ၊ Jinhua မြို့၊ Zhejiang ပြည်နယ်၊ တရုတ်နိုင်ငံ
အီလက်ထရွန်ရောင်ခြည်အငွေ့ပျံခြင်းအပေါ်ယံပိုင်း
ခုခံမှုရေငွေ့ပျံခြင်းအရင်းအမြစ်မှ ပံ့ပိုးပေးသော စွမ်းအင်သိပ်သည်းဆနည်းသော ခုခံမှုအပူပေးခြင်း၏ ချို့ယွင်းချက်အချို့ကြောင့် ရေငွေ့ပျံမှုရင်းမြစ်ကိုယ်တိုင် ရေငွေ့ပျံခြင်း စသည်တို့ကို ထိခိုက်စေသော ရေငွေ့ပျံမှုရင်းမြစ်အသစ်များကို ဖော်ထုတ်ရန် လိုအပ်ပါသည်။ Electron beam evaporation coating သည် အငွေ့ပျံသည့်ပစ္စည်းကို ရေအေးပေးထားသော crucible ထဲသို့ ထည့်ပေးပြီး၊ ဖလင်ပစ္စည်းကို အပူပေးရန်အတွက် အီလက်ထရွန်အလင်းတန်းကို တိုက်ရိုက်အသုံးပြုကာ ဖလင်ပစ္စည်းကို အငွေ့ပြန်စေပြီး ဖလင်တစ်ခုဖွဲ့စည်းရန် အောက်စထရိတွင် ပေါင်းစည်းထားသော အရေပြားနည်းပညာတစ်ခုဖြစ်သည်။ အီလက်ထရွန် အလင်းတန်းများ အငွေ့ပျံခြင်း အရင်းအမြစ်သည် 6000 ဒီဂရီစင်တီဂရိတ်အထိ အပူပေးနိုင်ပြီး အသုံးများသော ပစ္စည်းအားလုံးနီးပါး အရည်ပျော်နိုင်ပြီး သတ္တုများ၊ အောက်ဆိုဒ်များနှင့် ပလတ်စတစ်များကဲ့သို့ ပါးလွှာသော အလွှာများတွင် အရှိန်ပြင်းပြင်းဖြင့် အပ်နှံနိုင်သည်။
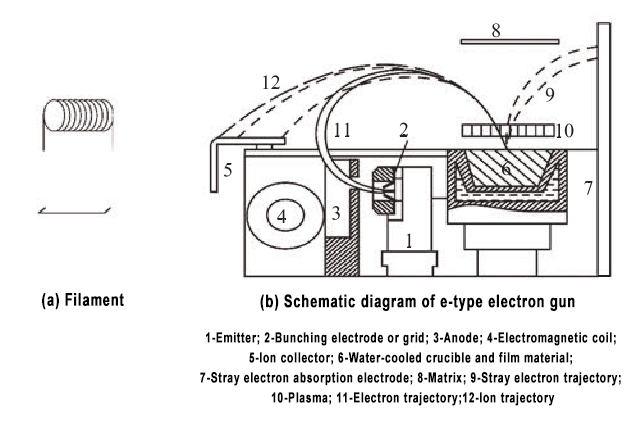
လေဆာသွေးခုန်နှုန်းစစ်ချက်
Pulsed လေဆာကြေးအစစ်ခံ (PLD)Target Target Target Target Target Target Target မှဖိစီးသောအပူချိန်မှဖိစီးသောအပူချိန်မြင့်တက်လာစေရန်စွမ်းအင်မြင့်လေဆာရောင်ခြည်ကိုအသုံးပြုသောရုပ်ရှင်ရိုက်ကူးခြင်းနည်းလမ်းတစ်ခုဖြစ်သည်။ နှင့်အလွှာအပေါ်ပါးလွှာသောရုပ်ရှင်ကိုဖွဲ့စည်း, အငွေ့ပျံ။
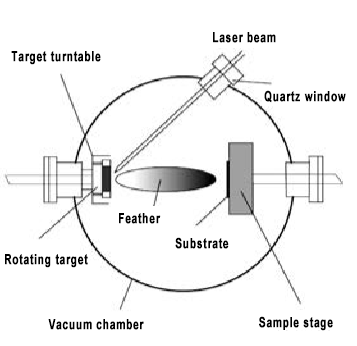
မော်လီကျူးအလင်းတန်း epitaxy
မော်လီကျူးရောင်ခြည် jappaigaxaxy (MBE) သည် EmitxAxial ရုပ်ရှင်အထူကိုတိကျစွာထိန်းချုပ်နိုင်သည့်ပါးလွှာသောရုပ်ရှင်ပြင်ဆင်မှုနည်းပညာဖြစ်သည်။ အဓိကအားဖြင့် Ultra-petch ရုပ်ရှင်ကဲ့သို့သော semiconductors များအတွက်မြင့်မားသောပါးလွှာသောရုပ်ရှင်များကိုပြင်ဆင်ရန်အတွက်အသုံးပြုသည်။ ၎င်းသည်မျိုးဆက်သစ်အီလက်ထရောနစ်ပစ္စည်းများနှင့် optoelelectronic ပစ္စည်းကိရိယာများအတွက်အဓိကပြင်ဆင်မှုနည်းပညာတစ်ခုဖြစ်သည်။
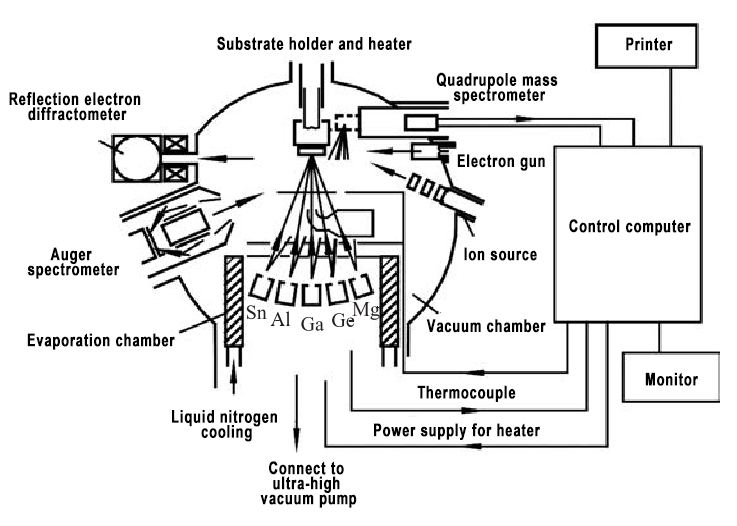
မော်လီကျူးရောင်ခြည် appitaxax သည်မတူညီသောအငွေ့စင်သိမ်းသွင်းရေးအရင်းအမြစ်များတွင် Crystal ၏အစိတ်အပိုင်းများကိုကွဲပြားခြားနားသောအရာ 1PA ၏အခြေအနေများတွင်ပြုလုပ်သောရုပ်ရှင်ကားများကိုဖြည်းဖြည်းချင်းအပူပေးပြီး, အပူရွေ့လျားမှုမြန်နှုန်းနှင့်အချိုးအစားတစ်ခုသည်အလွှာပေါ်ရှိ Estitaxial Plat ရုပ်ရှင်များကိုကြီးထွားစေပြီးကြီးထွားမှုဖြစ်စဉ်ကိုအွန်လိုင်းတွင်စောင့်ကြည့်သည်။
အနှစ်သာရအားဖြင့်၊ ၎င်းသည် မော်လီကျူး အလင်းတန်းများ ထုတ်လုပ်ခြင်း၊ မော်လီကျူး အလင်းတန်း ပို့ဆောင်ခြင်းနှင့် မော်လီကျူး အလင်းတန်းများ စုဆောင်းခြင်း အပါအဝင် လုပ်ငန်းစဉ် သုံးခု အပါအဝင် လေဟာနယ် အငွေ့ပျံခြင်း အလွှာဖြစ်သည်။ မော်လီကျူးအလင်းတန်း epitaxy ပစ္စည်းကိရိယာများ၏ schematic diagram ကို အထက်တွင်ပြထားသည်။ ပစ်မှတ်ကို အငွေ့ပျံသည့် အရင်းအမြစ်တွင် ထားရှိသည်။ အငွေ့ပျံခြင်းအရင်းအမြစ်တစ်ခုစီတွင် baffle တစ်ခုရှိသည်။ အငွေ့ပျံခြင်းအရင်းအမြစ်သည် အလွှာနှင့် ချိန်ညှိထားသည်။ အလွှာအပူပေးသည့်အပူချိန်ကို ချိန်ညှိနိုင်သည်။ ထို့အပြင်၊ အွန်လိုင်းတွင်ပါးလွှာသောဖလင်၏ပုံဆောင်ခဲဖွဲ့စည်းပုံကိုစောင့်ကြည့်ရန်စောင့်ကြည့်ကိရိယာတစ်ခုရှိသည်။
ဖုန်စုပ်စက် ဖုံးအုပ်ခြင်း။
ခိုင်လုံသောမျက်နှာပြင်ကိုတက်ကြွစွာအမှုန်များဖြင့်ထိုးနှက်သောအခါခိုင်ခံ့သောမျက်နှာပြင်ရှိအက်တမ်များသည်စွမ်းအင်အမှုန်များနှင့်တိုက်မိပြီးစွမ်းအင်နှင့်အရှိန်အဟုန်ကိုရရှိနိုင်ပါသည်။ ဤဖြစ်ရပ်ဆန်း sputtering ဟုခေါ်သည်။ Sputtering Cabingating ဆိုသည်မှာစွမ်းအင်အမှုန်များနှင့်အမှုန်များအမှုန်များကိုအစိုင်အခဲပစ်မှတ်များကိုအစိုင်အခဲပစ်မှတ်များကိုဗုံးကြဲခြင်း,
Cathode Target မျက်နှာပြင်ပေါ်ရှိသံလိုက်စက်ကွင်းပေါ်ရှိသံလိုက်စက်ကွင်းတစ်ခုနှင့်မိတ်ဆက်ပေးခြင်းအီလက်ထရွန်များကိုကန့်သတ်ရန် Electron Path ကိုတိုးချဲ့ရန်, ဤနိယာမအပေါ် အခြေခံ. အပေါ်ယံပိုင်းသောနည်းလမ်းကို Magnetron Sputering Cabutter ဟုခေါ်သည်။
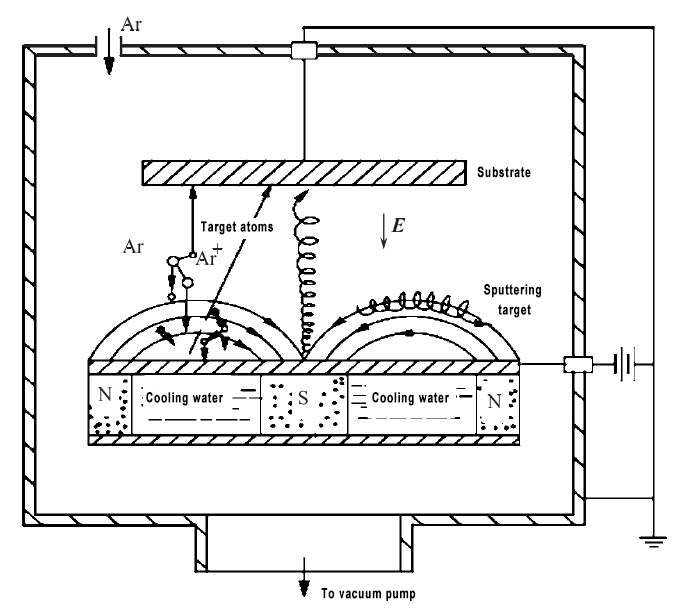
နိယာမကားချပ်DC Magnetron Sputteringအပေါ်မှာပြထားတဲ့အတိုင်းဖြစ်ပါတယ်။ လေဟာနယ်အခန်းထဲရှိအဓိကအစိတ်အပိုင်းများမှာ Magnetron Sputering Target နှင့်အလွှာတို့ဖြစ်သည်။ အလွှာနှင့်ပစ်မှတ်များသည်တစ် ဦး နှင့်တစ် ဦး ရင်ဆိုင်နေရပြီးအလွှာသည်အနှံ့အပြားရှိပြီးရည်မှန်းချက်မှာအနုတ်လက်ခဏာဗို့အားနှင့်ချိတ်ဆက်ထားသည်, ပစ်မှတ်ရန်။ သံလိုက်စက်ကွင်းကိုထုတ်လုပ်ရန်အသုံးပြုသောအမြဲတမ်းသံလိုက်ကိုပစ်မှတ်၏နောက်ကျောတွင် ထား. S သည် The Time မှ Term Magnet မှ Term Magnet မှသံလိုက်တိုင်၏သံလိုက်လိုင်းများကိုဖွဲ့စည်းပြီး Cathode Target မျက်နှာပြင်နှင့်အတူပိတ်ထားသောနေရာတစ်ခုကိုဖွဲ့စည်းသည်။
ပစ်မှတ်နှင့်သံလိုက်ရေအေးအားဖြင့်အအေးခံနေကြသည်။ Vacuum Chamber ကို 1e-3PA မှရွှေ့ပြောင်းထားသည့်အခါ AR သည်လေဟာနယ်အခန်းထဲသို့ 0 င်ရောက်သောအခါ, Argon Plasma ရှိ Argon Plasma ရှိ Argon အိုင်းယွန်းများသည်လျှပ်စစ်ဓာတ်အားကန်၏လုပ်ဆောင်မှုအောက်ရှိ cathode ကိုပစ်မှတ်သို့ပြောင်းရွှေ့သည်။
DC Sputtering Coating ဖြစ်စဉ်တွင်ဓာတ်ငွေ့များ, နိုက်ထရိုဂျင်, တက်ကြွသောအုပ်စုများကိုဖွဲ့စည်းရန်အက်တမ်များ။ ဤရွေ့ကား activated အုပ်စုများသည်အလွှာများ၏မျက်နှာပြင်သို့ပစ်မှတ်အက်တမ်များနှင့်အတူအလွှာများ၏မျက်နှာပြင်သို့ရောက်ရှိခြင်း, ဓာတုဗေဒဆိုင်ရာတုံ့ပြန်မှုများနှင့်အောက်ဆိုဒ်များ,
Vetek Semiconductor သည်တရုတ်ထုတ်လုပ်သူဖြစ်သည်Tantalum carbide အပေါ်ယံ, ဆီလီကွန်ကာဗိုက်အလွှာ, အထူးဂိဒ်, ဆီလီကွန်ကာဘက်ကာဗွန်ကြွေထည်နှင့်အခြား semiconductor ceramics. VeTek Semiconductor သည် ဆီမီးကွန်ဒတ်တာစက်မှုလုပ်ငန်းအတွက် အမျိုးမျိုးသော Coating ထုတ်ကုန်များအတွက် အဆင့်မြင့်ဖြေရှင်းချက်များအား ပံ့ပိုးပေးရန် ကတိပြုပါသည်။
သင့်တွင်မေးမြန်းစုံစမ်းလိုပါကသို့မဟုတ်နောက်ထပ်အသေးစိတ်အချက်အလက်များလိုအပ်ပါကကျွန်ုပ်တို့နှင့်ဆက်သွယ်ရန်မတွန့်ဆုတ်ပါနှင့်။
Mob/WhatsAPP- +86-180 6922 0752
အီးမေးလ်- anny@veteksemi.com



+86-579-87223657


Wangda လမ်း၊ Ziyang လမ်း၊ Wuyi ကောင်တီ၊ Jinhua မြို့၊ Zhejiang ပြည်နယ်၊ တရုတ်နိုင်ငံ
မူပိုင်ခွင့် © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. မူပိုင်ခွင့်ကိုလက်ဝယ်ထားသည်။
Links | Sitemap | RSS | XML | ကိုယ်ရေးအချက်အလက်မူဝါဒ |
